英特尔近日举办了一场代工业务网络研讨会。除了展示代工部门独立计算在财务上带来的变化外,该研讨会还分享了英特尔代工未来的技术发展路线图。
根据制程工艺路线图,英特尔目标到 18A 节点重新成为一流代工厂,并在 14A 节点确立领先地位。
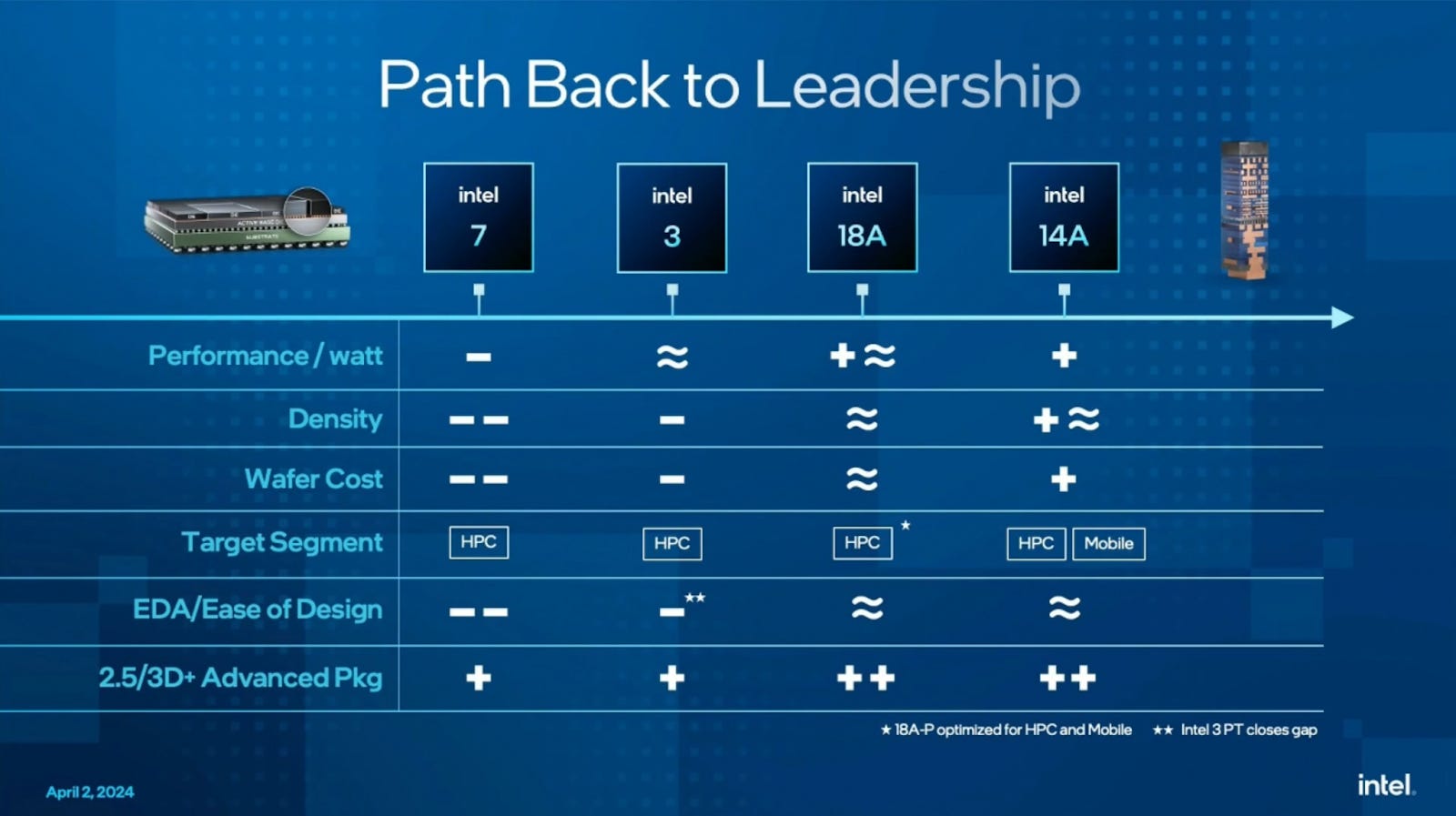
在功耗方面,目前已有的 Intel 7 节点落后于竞争对手,英特尔计划于近期的 Intel 3 节点与行业领先企业(台积电)相当,同时在未来的 18A 节点实现略好于竞争对手的水平,并于 14A 节点确认优势。
而在密度方面,目前的 Intel 7 节点存在明显劣势,英特尔希望通过 Intel 3 节点缩小差距,并在 18A 节点追上竞争者,而在 14A 节点上可获得较小的密度优势。
Intel 7 节点的晶圆成本明显高于业界水平,英特尔希望通过从 Intel 3 到 14A 的演进,逐渐实现较低的晶圆成本。
同时,未来数年将见证英特尔制程目标市场的扩展,到 14A 节点英特尔将可对外代工移动端产品。
英特尔将逐步弥补在传统 IDM 模式下对外部 EDA 支持的欠缺,将设计便捷度提升到业界平均水平。
此外英特尔还将进一步扩大在 2.5D / 3D 等先进封装技术上的优势。
作为面向 AI 时代的系统代工厂,英特尔表示将通过多个层面的创新让摩尔定律继续前进。

互连方面,除了适用于 AI 的网卡和芯粒 UCIe 互连,英特尔还将发力硅光子学,并丰富在 PCIe、SerDes 领域的技术储备。
英特尔目前可通过浸没式液冷冷却 1000W TDP 的芯片,目标到 2030 年实现对 2000W 芯片的冷却;
在先进内存方向上,英特尔目前可通过 EMIB 连接 8 个 HBM 堆栈,未来该能力将提升至 12 个堆栈乃至更多,同时英特尔也在探索更新的内存解决方案。
对于 Foveros 3D Direct 高级封装,英特尔目标到 2027 年左右实现 4 微米的连接间隙。
英特尔此次还给出了更详细的玻璃基板应用时间,这项技术的运用有望于 2027 年展开,稍晚于IT之家此前报道中三星电机设立的 2026 年目标。 










