据业内人士透露,台积电已针对数据中心市场推出了其新型先进封装技术——COUPE异构集成技术。
电子信令和处理是信号传输和处理的主流技术。近年来,尤其由于信号传输的有关光纤应用的使用,光学信令和处理已经用于日益增加的更多应用中。
为此,台积电于2019年6月20日申请了一项名为“集成光子封装件、光子封装件及其形成方法”的发明专利(申请号: 201910538989.4),申请人为台湾积体电路制造股份有限公司。
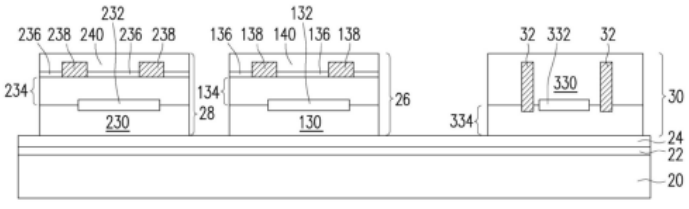
图1 光子封装件形成过程截面图
图1为本发明提出的光子封装件形成过程截面图,示出了载体20和形成在其上方的释放膜22。载体是玻璃载体、陶瓷载体等,具有圆形顶视图。释放膜由聚合物基材料形成,从在随后步骤中形成的上覆结构中一起去除该释放膜和载体。本发明中的释放膜由环氧基热释放材料形成,以可流动的方式进行分配并被固化。释放膜是层压膜并且层压在载体上。其顶面是平坦的并且具有高度共平面性,管芯附接膜24为粘合膜,形成在释放膜上方,可以涂覆或层压在释放膜上。
电子管芯26、器件管芯28、和光子管芯30附接至管芯附接膜。电子管芯作为中央处理器,包括控制光子管芯中的多个器件操作的控制电路。另外还包括处理电信号的电路,从光子管芯中的光学信号转换为电信号。电子管芯又包括半导体衬底130,衬底背面与管芯附接膜接触。互连结构134形成在衬底的正面上,包括介电层和金属线与通孔等。电连接器138是嵌入介电层140中的金属柱,通过互连结构电连接至集成电路器件,金属柱可以延伸到钝化层136中。
附加管芯放置在管芯附接膜上,而管芯设计为相应封装件的功能的专用集成电路管芯,包括半导体衬底230,其背面与管芯附接膜接触。集成电路器件232包括位于衬底的正面处的至少部分。互连结构234形成在衬底的正面上,并且包括多个介电层、多个金属线和通孔等。电连接器238通过互连结构电连接至集成电路器件。
简而言之,台积电的集成封装专利,通过将光学信号及电信号处理结构结合,并减小多个光子管芯的尺寸,能够增加产量,并显著降低了制造成本。
台积电致力于为全球逻辑IC产业提供最具价值的专业积体电路制造服务,多样化的晶片生产有助于缓和需求的波动性,使公司得以维持较高的产能利用率及获利率,以及稳健的投资报酬。 










